专利的化学沉铜前处理工艺
传统的孔金属化工艺化学沉铜历史已超过 30 年,我司更是此工艺的创始者之一,我们开发的 M-System/M-85 高速沉铜工艺,在过去 20 年的生产纪录中,建立了零孔破的工艺标准。依循着这一优良的专利前处理工艺, 我司再度开发了更高信赖度的 M-Copper Omega 。
M-System
M-System 工艺包含除胶渣和化学沉铜 2 个制程,依据大量产的统计数据,开发出满足新世代的印刷电路板的需求。该工艺的第一步骤是化学除胶渣;参数设计适合处理各种特殊树脂系统。同时也适合用于垂直或水平设备以因应各种类型的 PCB;例如多层印刷电路板、柔性电路板。
第二步骤是我们先进的化学沉铜工艺,提供低速沉积铜、中速沉积铜以及高速沉积铜! 该工艺的核心是我们的 M-Condition 系列整孔剂,药水选择与材料类型匹配,包括 FR-4 环氧树脂,聚酰亚胺,柔性或高频,低损耗材料。而我们专利的活化钯系统 M-Activate,均匀完整的吸附在玻纤和树脂表面,而同时又有效的减少在铜箔上的吸附量。同时搭配我们的专利速化系统 M-Accelerate,可以提供卓越的背光结果和优异的结合力、信赖性! 能够抵抗组装时的多次回焊热应力!。因应各种不同厚度的化学沉积铜需求,无论是垂直设备或是水平设备,M-Copper 化学沉铜都有多种系统可供选择!

M-Copper Omega
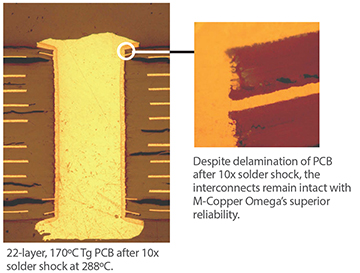
M-Copper Omega 是采用了我司专利的活化系统和统计设计的化学沉铜。专利的活化步骤采用非传统的整孔和速化步骤以强化在玻纤上的沉积覆盖率,后续连接图型电镀流程也可以得到优良、完整的孔壁镀铜层!。统计设计的化学沉铜槽,搭配良好的设备辅助,在高纵横比通孔以及盲孔上都能够有杰出优异的品质良率!
随着市场对树脂材料的功能要求越来越多,导入越来越多Hi-Tg树脂,对于孔金属化工艺的挑战也越大。Hi-Tg树脂材料的化学反应性差,化学加工困难度比起传统树脂更困难。因此,我司克服各种问题点,研发设计出 M-Copper Omega 来解决这个问题!
M-Copper 15
我司的低速化学沉铜 MacDermid Enthone M-Copper 15 操作条件的容许规格范围宽,是特别针对需要降低生产成本的厚板生产厂商的需求而设计开发出来的产品!
M-Copper 15 于15分钟沉积 15 微英寸化学沉铜,药水负载量的可操作范围宽; 所以挂篮或挂架式的生产设备都适用。 药水负载量范围 = 0.20 – 1.75 SSF/gal,低沉积量可以有效的降低药水的消耗量!高信赖性的 M-Copper 15 沉积层是低应力的设计,提高了孔壁结合力。M-Copper 15 的低氢析出,可以在高纵横比孔的中心沉积均匀的化学沉铜。M-Copper 15沿袭了我司的专利活化步骤。
M-Copper 15 是您高技术含量印刷电路板的最佳选择
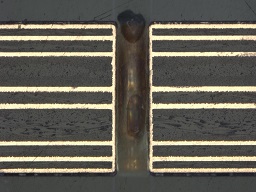
Via Dep 4550
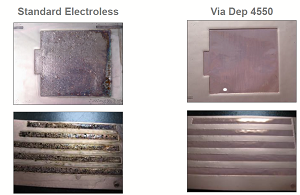
传统的化学沉铜在光滑、化学反应性差的材料常会有鼓泡 (Blister) 的现象。低应力的 Via Dep 4550 则是为解决此现象而开发的,无鼓泡的问题。
我司的 MacDermid Enthone Via Dep 4550 化学沉铜系统是用于电镀困难的材料金属化的首选。 4550工艺提供出色的粘附力于惰性难镀表面和困难的结构设计,同时保持结构完整性。零应力和无气泡的沉积可以轻松满足满足 SAP,MSAP和柔性电路板复杂的孔金属化需求。
传统的化学沉铜在光滑,低结合力的材料常会有空泡(Blister) 的问题。低应力高结合力Via Dep 4550 则是为此而开发的,无空泡的问题。
.
AP 材料的7 Mil盲孔 – 传统化学沉铜
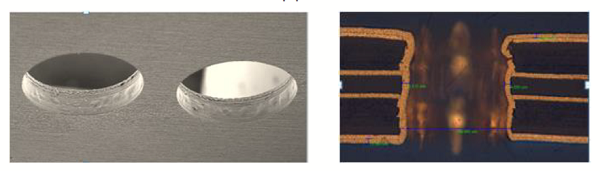
AP 材料的7 Mil盲孔 – Via Dep 4550

特性优点:
· 无应力铜沉积
· 环保的酒石酸系统
· 低工作温度,节省操作成本
· 可以兼容软板,软硬结合板和硬板的PCB设计
· 直接替代现有的化学沉铜线
· 通过 IPC – TM – 650 导通孔热应力测试






